QR kód

produkty
Kontaktujte nás


Fax
+86-579-87223657

E-mailem

Adresa
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Čína
Substráty karbidu křemíku mají mnoho defektů a nelze je zpracovat přímo. K vytvoření čipových oplatků je třeba na ně pěstovat specifický tenko krystalový tenký film. Tento tenký film je epitaxiální vrstva. Téměř všechna zařízení na karbidu křemíku jsou realizována na epitaxiálních materiálech. Vysoce kvalitní homogenní epitaxiální materiály křemíku křemíku jsou základem pro vývoj křemíkových karbidových zařízení. Výkon epitaxiálních materiálů přímo určuje realizaci výkonu silikonových karbidových zařízení.
Vysoce proudová a vysoce reliabilita silikonový karbid zařízení předložily přísnější požadavky na morfologii povrchu, hustotu defektů, dopingu a tloušťku uniformity epitaxiálních materiálů. Velká velikosti, nízká defektní hustota a vysoká nejednotnostEpitaxy karbidu křemíkuse stal klíčem k rozvoji průmyslu křemíkového karbidu.
Příprava vysoce kvalitníEpitaxy karbidu křemíkuVyžaduje pokročilé procesy a zařízení. Nejčastěji používanou metodou epitaxiálního růstu křemíkového karbidu je chemická depozice par (CVD), která má výhody přesné kontroly tloušťky epitaxiálního filmu a dopingové koncentrace, méně defektů, mírné rychlosti růstu a automatické kontroly procesu. Je to spolehlivá technologie, která byla úspěšně komercializována.
CVD Epitaxy karbidu křemíku obvykle používá zařízení CVD horké stěny nebo teplé stěny, což zajišťuje pokračování epitaxiální vrstvy 4H krystalické sic za podmínek vyšší růstové teploty (1500-1700 ℃). Po letech vývoje může být horká stěna nebo teplá stěna CVD rozdělena do horizontální horizontální struktury reaktorů a vertikální vertikální struktury reaktory podle vztahu mezi směrem toku vstupního plynu a povrchem substrátu.
Kvalita epitaxiální pece na křemíku má hlavně tři ukazatele. Prvním je epitaxiální růstová výkonnost, včetně uniformity tloušťky, dopingové uniformity, rychlosti defektu a rychlosti růstu; Druhým je teplotní výkon samotného zařízení, včetně rychlosti zahřívání/chlazení, maximální teploty, teplotní uniformity; a konečně nákladová výkonnost samotného zařízení, včetně jednotkové ceny a výrobní kapacity.
Horizontální CVD horké stěny, planetární CVD teplé stěny a kvazi-horké stěny vertikální CVD jsou technologická řešení hlavního proudu, která se v této fázi komerčně používají. Toto tři technické vybavení mají také své vlastní vlastnosti a lze je vybrat podle potřeb. Schéma struktury je uvedena na obrázku níže:

Horizontální CVD systém horké stěny je obecně rozsáhlý růstový systém s velkým pádem poháněným leteckou flotací a rotací. Je snadné dosáhnout dobrých ukazatelů ve voze. Reprezentativním modelem je PE1O6 společnosti LPE v Itálii. Tento stroj může realizovat automatické načítání a vykládání oplatků při 900 ℃. Hlavními rysy jsou vysoká míra růstu, krátký epitaxiální cyklus, dobrá konzistence v rámci oplatky a mezi pecemi atd. Má nejvyšší podíl na trhu v Číně.

According to LPE official reports, combined with the usage of major users, the 100-150mm (4-6 inches) 4H-SiC epitaxial wafer products with a thickness of less than 30μm produced by the Pe1O6 epitaxial furnace can stably achieve the following indicators: intra-wafer epitaxial thickness non-uniformity ≤2%, intra-wafer doping concentration non-uniformity ≤5%, surface defect density ≤ 1cm-2, plocha bez povrchu (buňka jednotky 2 mm × 2 mm) ≥ 90%.
Domácí společnosti jako JSG, CETC 48, Naura a NASO vyvinuly monolitické epitaxiální zařízení karbidu křemíku s podobnými funkcemi a dosáhly rozsáhlých zásilek. Například v únoru 2023 vydala společnost JSG 6-palcové epitaxiální vybavení s dvojitým vozem SIC. Zařízení používá horní a dolní vrstvy horních a dolních vrstev grafitových částí reakční komory k růstu dvou epitaxiálních destiček v jedné peci a horní a dolní procesní plyny lze samostatně regulovat, s teplotním rozdílem ≤ 5 ° C, což účinně tvoří pro rozlišení produkční kapacity monolitických epitaxových epitaxů.Sic povlak Halfmoon části. Dodáváme uživatelům 6 palců a 8 palců.

Systém CVD teplé stěny s planetárním uspořádáním základny je charakterizován růstem více oplatků v jedné peci a vysokou účinností výstupu. Reprezentativní modely jsou AIXG5WWC (8x150 mm) a G10-SIC (9 x 150 mm nebo 6 × 200 mm) Epitaxiální zařízení Aixtron Německa.
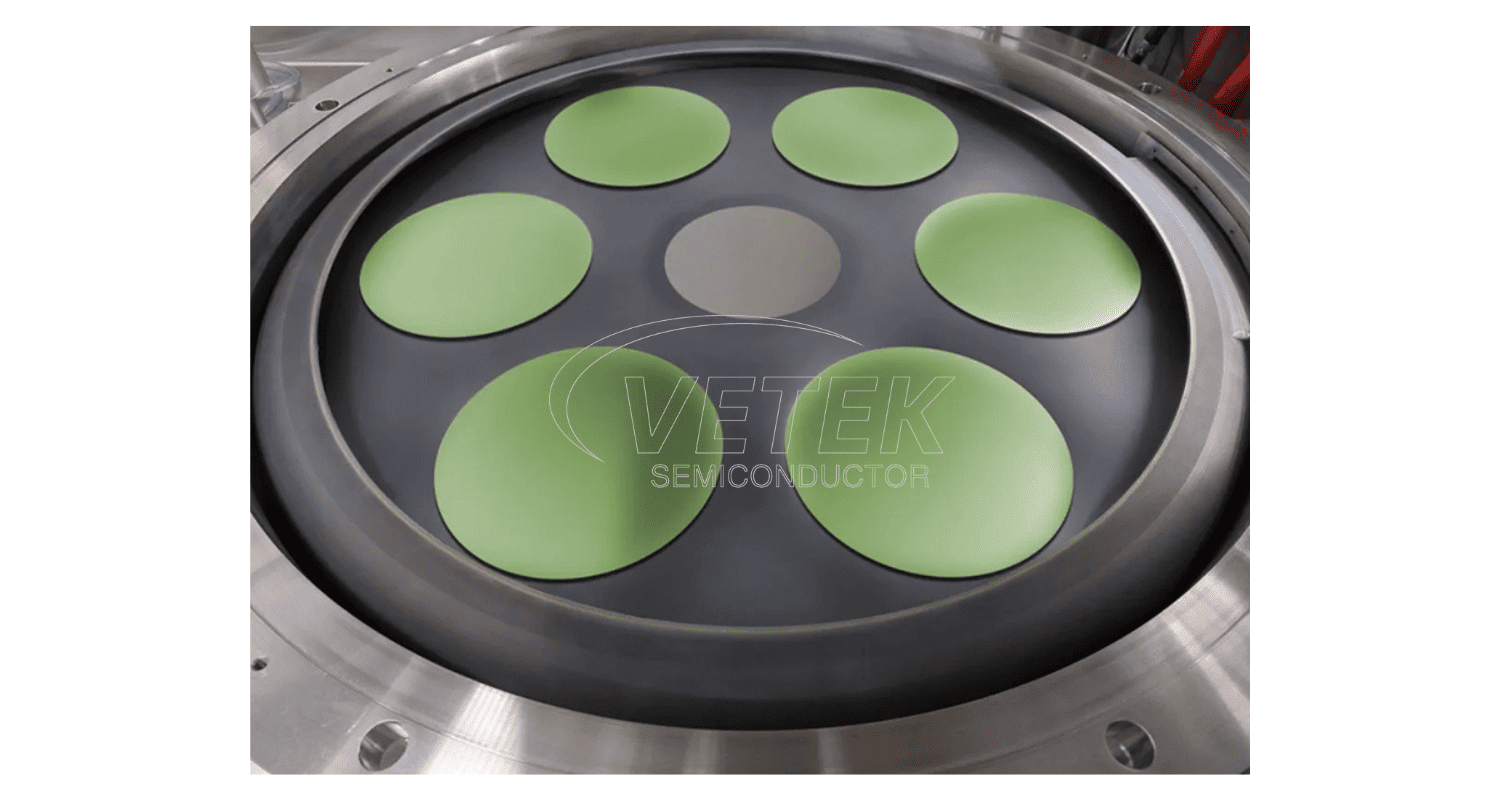
According to Aixtron's official report, the 6-inch 4H-SiC epitaxial wafer products with a thickness of 10μm produced by the G10 epitaxial furnace can stably achieve the following indicators: inter-wafer epitaxial thickness deviation of ±2.5%, intra-wafer epitaxial thickness non-uniformity of 2%, inter-wafer doping concentration deviation of ±5%, intra-wafer doping Koncentrace nejednotnost <2%.
Až dosud je tento typ modelu zřídka používán domácími uživateli a údaje o dávkách jsou nedostatečné, což do jisté míry omezuje jeho inženýrskou aplikaci. Kromě toho vzhledem k vysokým technickým bariérám epitaxiálních pecí s více vlivami z hlediska kontroly teplotního pole a pole průtoku je vývoj podobného domácího vybavení stále ve fázi výzkumu a vývoje a mezitím neexistuje žádný alternativní model. Mezitím můžeme poskytnout Aixtron Planetárního susceptoru nebo 8 palců s nátěrem nebo sic potahováním.
Systém svislého CVD kvazi-horké stěny se otáčí hlavně vysokou rychlostí prostřednictvím vnější mechanické pomoci. Jeho charakteristikou je, že tloušťka viskózní vrstvy je účinně snížena nižším tlakem reakční komory, čímž se zvyšuje rychlost růstu epitaxiálního. Současně její reakční komora nemá horní stěnu, na které lze ukládat částice SIC, a není snadné produkovat padající objekty. Má přirozenou výhodu při kontrole defektů. Reprezentativní modely jsou jednorázové epitaxiální pece Epirevos6 a Epirevos8 japonské Nuflare.
Podle Nuflare může rychlost růstu zařízení Epirevos6 dosáhnout více než 50 μm/h a hustota povrchu defektu epitaxiální destičky může být řízena pod 0,1 cm-²; Pokud jde o kontrolu s uniformitou, inženýr Nuflare Yoshiaki Daigo oznámil, že výsledky uniformity v rámci mezery 10 μm silné 6palcové epitaxiální oplatky pěstované pomocí Epirevos6 a tloušťka uvnitř vlivu a koncentrace dopingu jako 1% a 2,6%.Horní grafitový válec.
V současné době výrobci domácích zařízení, jako jsou základní třetí generace a JSG, navrhli a spustili epitaxiální zařízení s podobnými funkcemi, ale nebyly ve velkém měřítku používány.
Obecně mají tři typy zařízení své vlastní vlastnosti a zabírají určitý podíl na trhu v různých potřebách aplikací:
Struktura horizontální CVD horké stěny obsahuje ultra rychlé tempo růstu, kvalitu a uniformitu, jednoduchý provoz a údržba zařízení a zralé rozsáhlé výrobní aplikace. Avšak vzhledem k typu jednoho volu a časté údržbě je účinnost výroby nízká; Teplé planetární CVD teplé stěny obecně přijímá 6 (kus) × 100 mm (4 palce) nebo 8 (kus) × 150 mm (6 palců) struktury zásobníku, která výrazně zlepšuje účinnost výroby zařízení, pokud jde o výrobní kapacitu, ale je obtížné kontrolovat konzistenci více kusů a produkční výnos je stále největším problémem; Kvazi-horká stěna vertikální CVD má komplexní strukturu a kvalitní kontrola vady epitaxiální produkce oplatky je vynikající, což vyžaduje extrémně bohaté údržbu zařízení a zkušenosti s použitím.
Rychlá rychlost růstu
jednoduchý Struktura zařízení a
Pohodlná údržba
Velká výrobní kapacita
vysoká účinnost výroby
Dobrá kontrola vady produktu
dlouhá reakční komora
cyklus údržby
Komplexní struktura
obtížné ovládat
konzistence produktu
Složitá struktura zařízení,
obtížná údržba
Zástupce
zařízení
Výrobci
Horizontální CVD s horkou stěnou
Planetární CWD v teplé stěně
Kvazi-horká stěna vertikální CTD
Výhody
Nevýhody
Krátký cyklus údržby
Itálie LPE, Japonsko Tel
Německo Aixtron
Japan Nuflare
S nepřetržitým vývojem odvětví budou tyto tři typy zařízení iterativně optimalizovány a vylepšeny z hlediska struktury a konfigurace zařízení se stane stále dokonalejší a bude hrát důležitou roli při porovnávání specifikací epitaxiálních oplatků s různými tloušťkami a požadavky na defekty.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Čína
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Všechna práva vyhrazena.
Links | Sitemap | RSS | XML | Zásady ochrany osobních údajů |
