QR kód

produkty
Kontaktujte nás


Fax
+86-579-87223657

E-mailem

Adresa
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Čína
V továrně Fab je mnoho typů měřicích zařízení. Následuje některé běžné vybavení:
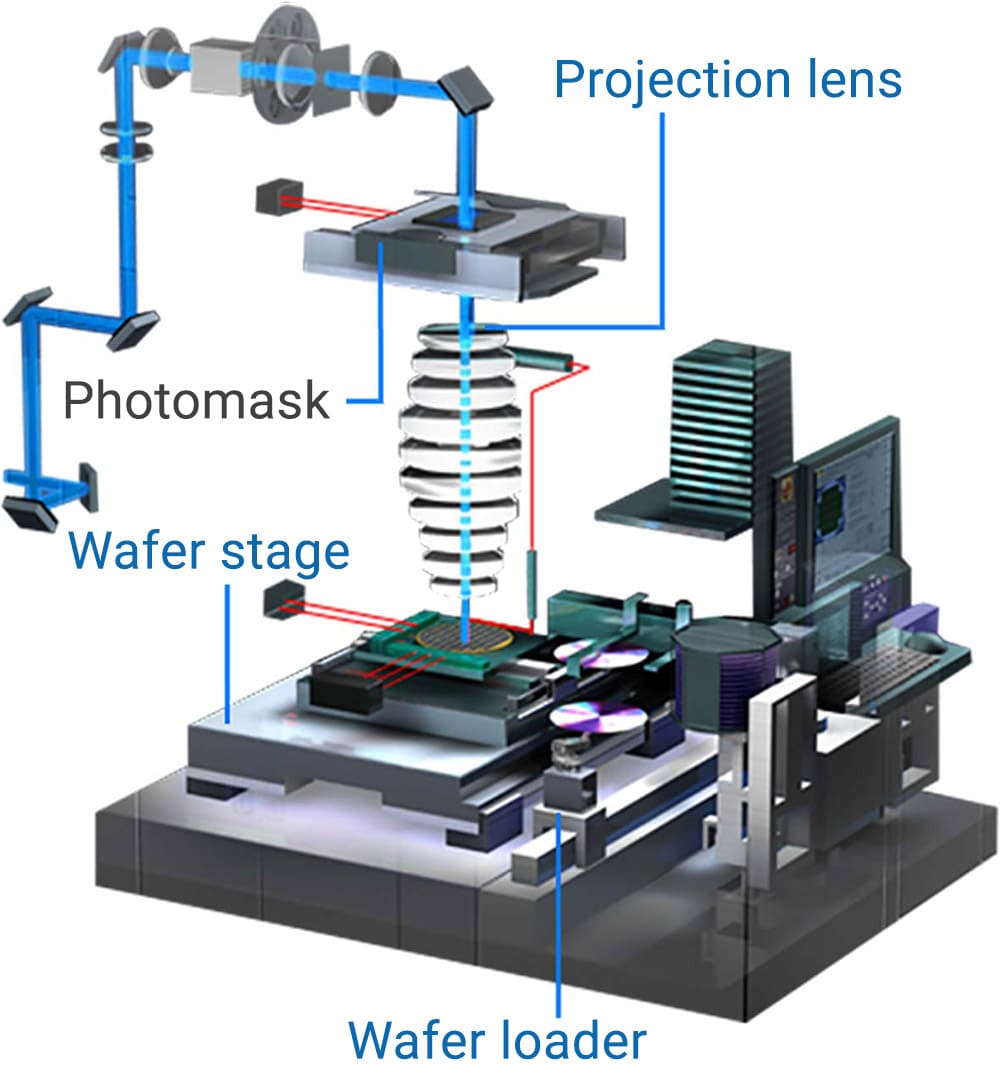
• Fotolitografická stroj Zarovnání přesnosti měření zařízení: například systém zarovnání ASML, který může zajistit přesnou superpozici různých vzorů vrstvy.
• Přístroj pro měření tloušťky fotorezistů: Včetně elipsometrů atd., Které vypočítají tloušťku fotorezistu na základě polarizačních charakteristik světla.
• Detekční zařízení Adit a AEI: Detekujte účinek fotorezistického vývoje a kvalitu vzorů po fotolitografii, jako je příslušná detekční zařízení VIP optoelectronics.
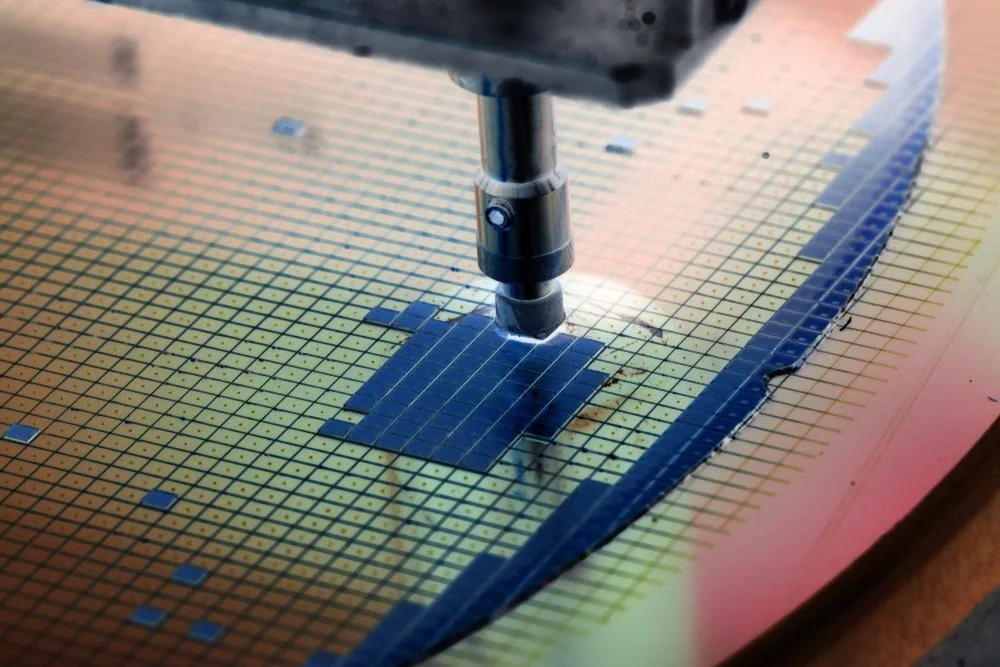
• Zařízení pro měření hloubky leptání: jako je interferometr bílého světla, který může přesně měřit mírné změny hloubky leptání.
• Přístroj pro měření profilu leptání: Pomocí elektronového paprsku nebo technologie optického zobrazování pro měření informací o profilu, jako je úhel boční stěny vzoru po leptání.
• CD-SEM: Může přesně měřit velikost mikrostruktur, jako jsou tranzistory.

• Přístroje pro měření tloušťky filmu: Optické reflektory, rentgenové reflektory atd. Mohou měřit tloušťku různých filmů uložených na povrchu oplatky.
• Zařízení pro měření filmového stresu: Měřením napětí generovaného filmem na povrchu oplatky se posuzuje kvalita filmu a jeho potenciální dopad na výkon oplatky.
![]()
• Zařízení pro měření dávky iontových implantací: Určete dávku implantace iontu monitorováním parametrů, jako je intenzita paprsku během implantace iontu nebo provádění elektrických testů na oplatce po implantaci.
• Dopingová koncentrace a distribuce měření zařízení: Například sekundární iontové hmotnostní spektrometry (SIMS) a šíření sond rezistence (SRP) mohou měřit koncentraci a distribuci dopingových prvků v oplatce.
![]()
• Měřicí zařízení po lemování roviny: Pomocí optických profilometrů a dalšího vybavení měření rovinnosti povrchu oplatky po leštění.
• Měřicí zařízení pro odstranění leštění: Určete množství odstraněného materiálu během leštění měřením hloubky nebo změny tloušťky značky na povrchu oplatky před a po leštění.
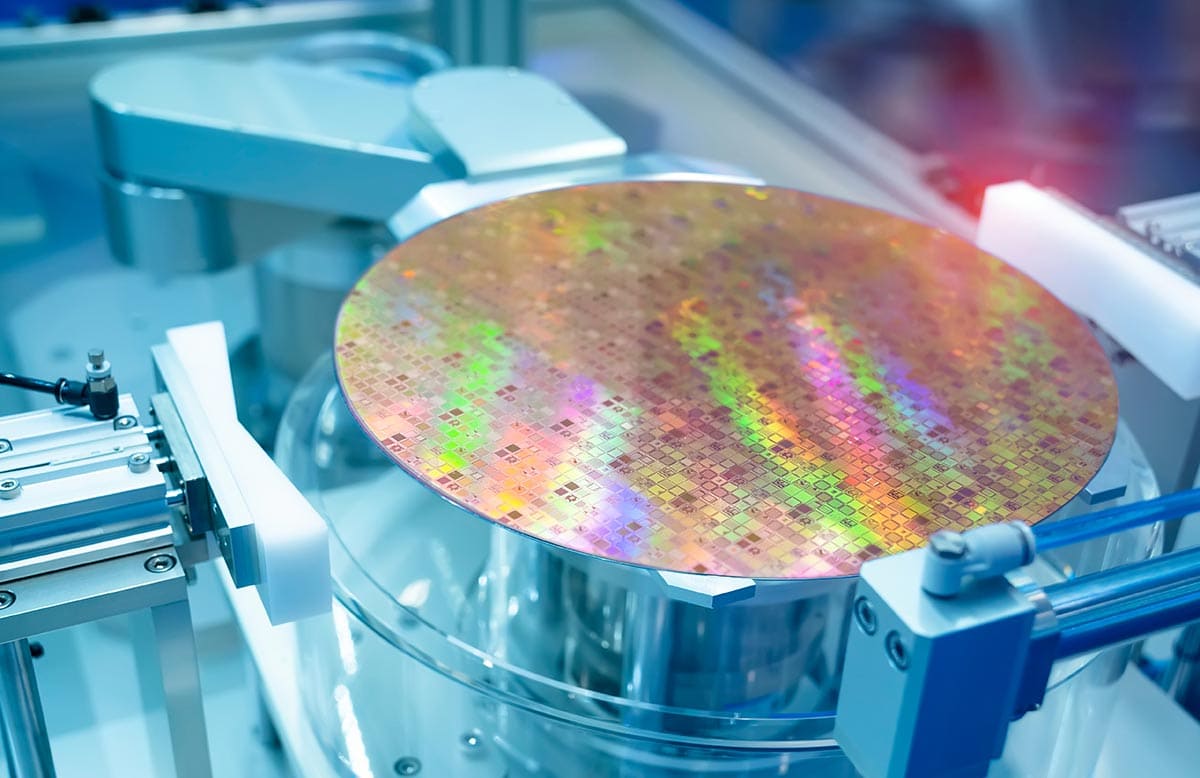
• KLA SP 1/2/3/5/7 a další vybavení: může účinně detekovat kontaminaci částic na povrchu oplatky.
• Série Tornado: Tornádo série zařízení VIP optoelectronics může detekovat defekty, jako jsou částice na oplatce, generovat mapy defektů a zpětnou vazbu k souvisejícím procesům pro nastavení.
• Inteligentní vizuální inspekční zařízení Alfa-X: Prostřednictvím systému řízení obrazu CCD-AI pomocí technologie posunutí a vizuálního snímání rozliší defekty a defekty, jako jsou částice na povrchu oplatky.
Jiné měřicí zařízení
• Optický mikroskop: Používá se k pozorování mikrostruktury a defektů na povrchu oplatky.
• Skenovací elektronový mikroskop (SEM): může poskytnout obrazy s vyšším rozlišením pro pozorování mikroskopické morfologie povrchu oplatky.
• Mikroskop atomové síly (AFM): can measure information such as the roughness of the wafer surface.
• Elipsometr: Kromě měření tloušťky fotorezistu lze také použít k měření parametrů, jako je index tloušťky a lomu tenkých filmů.
• Tester s čtyřmi smyčkami: Používá se k měření parametrů elektrického výkonu, jako je odpor oplatky.
• Rentgenový difraktometr (XRD): Může analyzovat strukturu krystalu a stresový stav destiček.
• Rentgenový fotoelektronový spektrometr (XPS): Používá se k analýze elementárního složení a chemického stavu povrchu oplatky.
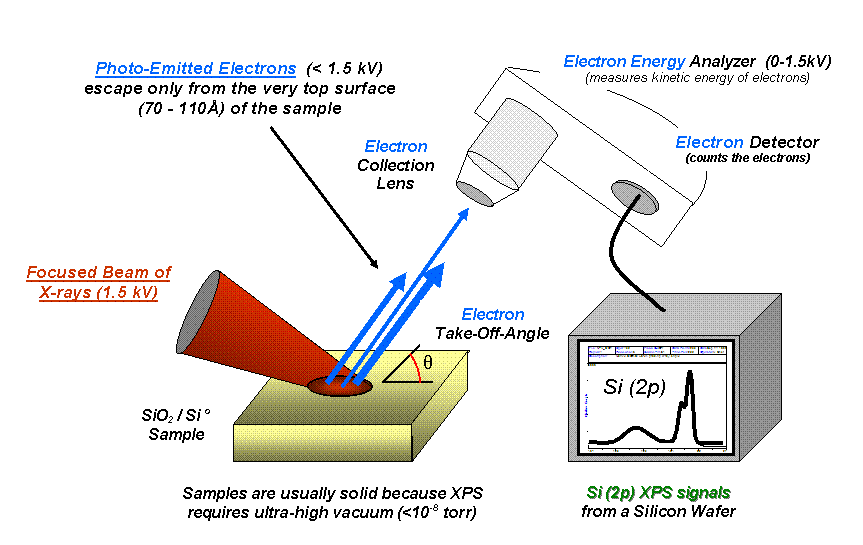
• Mikroskop zaměřeného iontového paprsku (FIB): může provádět zpracování a analýzu mikronono na oplatkách.
• Vybavení makra ADI: jako je kruhový stroj, používaný pro makro detekci defektů vzorů po litografii.
• Detekční zařízení vady masky: Detekujte defekty na masce, aby se zajistila přesnost litografického vzoru.
• Přenosový elektronový mikroskop (TEM): Může pozorovat mikrostrukturu a defekty uvnitř oplatky.
• Senzor měření bezdrátové teploty: Vhodné pro různé procesní zařízení, měření přesnosti teploty a uniformitu.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Čína
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Všechna práva vyhrazena.
Links | Sitemap | RSS | XML | Zásady ochrany osobních údajů |
