QR kód

produkty
Kontaktujte nás


Fax
+86-579-87223657

E-mailem

Adresa
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Čína
Výroba každého polovodičového produktu vyžaduje stovky procesů a celý výrobní proces je rozdělen do osmi kroků:zpracování oplatky - oxidace - Fotolitografie - lept - Depozice tenkého filmu - propojení - testování - obal.
![]()
Krok 1:Zpracování oplatky
Všechny polovodičové procesy začínají zrnem písku! Protože křemík obsažený v písku je surovina potřebná k výrobě oplatků. Destičky jsou kulaté plátky vyříznuty z jednokrystalových válců vyrobených z křemíku (SI) nebo arzenidu gallia (GaAS). Pro extrahování vysoce čistého křemíkového materiálu je nutný křemičitý písek, speciální materiál s obsahem oxidu křemičitého až 95%, což je také hlavní surovinou pro výrobu oplatků. Zpracování oplatky je proces výroby výše uvedených oplatků.
Ingot casting
Nejprve musí být písek zahříván, aby se v něm oddělil oxid uhelnatý a křemík, a proces se opakuje, dokud se nezíská ultra vysokou čistotu elektronického stupně (např. SI). Silikon s vysokým obsahem čistoty se roztaví na kapalinu a poté ztuhne do jediné krystalové pevné formy, nazývané „ingot“, což je první krok ve výrobě polovodičů.
Přesnost výroby silikonových ingotů (silikonové sloupy) je velmi vysoká, dosahuje úrovně nanometru a široce používanou metodou výroby je metoda Czochralski.
Ingot řezání
Po dokončení předchozího kroku je nutné odříznout dva konce ingotu s diamantovou pilou a poté ji nakrájet na tenké plátky určité tloušťky. Průměr ingotského řezu určuje velikost oplatky. Větší a tenčí oplatky lze rozdělit na více použitelných jednotek, což pomáhá snižovat výrobní náklady. Po řezání křemíkového ingotu je nutné přidat na plátky značky „ploché plochy“ nebo „dent“, aby se usnadnilo nastavení směru zpracování jako standardu v následujících krocích.
Leštění povrchu oplatky
Plátky získané prostřednictvím výše uvedeného procesu řezání se nazývají „holé oplatky“, tj. Nezpracované „surové oplatky“. Povrch holé oplatky je nerovnoměrný a vzorec obvodu nelze na něm vytisknout přímo. Proto je nutné nejprve odstranit povrchové defekty pomocí broušení a chemických leptacích procesů, poté vyleštěte, aby vytvořily hladký povrch a poté odstranily zbytkové kontaminanty čištěním, abyste získali hotovou oplatku s čistým povrchem.
Krok 2: Oxidace
Úlohou oxidačního procesu je vytvořit ochranný film na povrchu oplatky. Chrání oplatku před chemickými nečistotami, zabraňuje vstupu do obvodu do obvodu, zabraňuje difúzi během implantace iontů a zabraňuje sklouznutí oplatky během leptání.
Prvním krokem oxidačního procesu je odstranění nečistot a kontaminantů. Vyžaduje čtyři kroky k odstranění organické hmoty, nečistot kovu a odpaření zbytkové vody. Po čištění může být oplatka umístěna do vysokoteplotního prostředí 800 až 1200 stupňů Celsia a vrstva oxidu křemíku (tj. „Oxid“) je tvořena tokem kyslíku nebo páry na povrchu oplatky. Kyslík difunduje oxidovou vrstvou a reaguje s křemíkem za vzniku oxidové vrstvy různé tloušťky a jeho tloušťku lze měřit po dokončení oxidace.

Suchá oxidace a oxidace mokré v závislosti na různých oxidantech v oxidační reakci lze proces tepelné oxidace rozdělit na suchou oxidaci a oxidaci mokré. První z nich používá čistý kyslík k výrobě vrstvy oxidu křemíkového oxidu, která je pomalá, ale oxidová vrstva je tenká a hustá. Ten vyžaduje jak kyslík, tak vysoce rozpustnou vodu, která je charakterizována rychlou rychlostí růstu, ale relativně silnou ochrannou vrstvou s nízkou hustotou.
Kromě oxidantu existují i jiné proměnné, které ovlivňují tloušťku vrstvy oxidu křemíkového oxidu. Za prvé, struktura oplatky, její povrchové defekty a vnitřní koncentrace dopingu ovlivní rychlost generování oxidové vrstvy. Kromě toho, čím vyšší je tlak a teplota generovaná oxidačním zařízením, tím rychleji bude generována oxidová vrstva. Během oxidačního procesu je také nutné použít fiktivní list podle polohy oplatky v jednotce, aby se chránila oplatka a snížila rozdíl v oxidačním stupni.
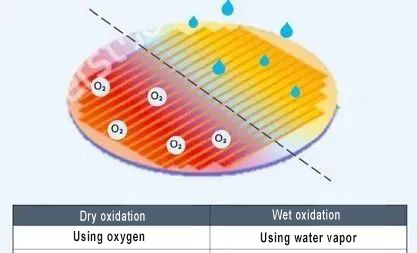
Krok 3: Fotolitografie
Fotolitografie je „tisknout“ obvodní vzor na oplatku přes světlo. Můžeme to pochopit jako kreslení rovinové mapy potřebné pro výrobu polovodičů na povrchu oplatky. Čím vyšší je jemnost vzoru obvodu, tím vyšší je integrace hotového čipu, čehož musí být dosaženo prostřednictvím pokročilé fotolitografické technologie. Konkrétně lze fotolitografii rozdělit do tří kroků: potahovací fotorezist, expozice a vývoj.
Povlak
Prvním krokem nakreslení obvodu na oplatku je obal fotorezistu na oxidové vrstvě. Fotorezist dělá z oplat „foto papírem“ změnou jeho chemických vlastností. Čím tenčí fotorezistická vrstva na povrchu oplatky, čím jednotnější je povlak a tím jemnější je vzorec, který lze vytisknout. Tento krok lze provést metodou „Spin Coating“. Podle rozdílu v reaktivitě světla (ultrafialové) lze fotorezisty rozdělit na dva typy: pozitivní a negativní. První z nich se po vystavení světlu rozloží a zmizí a ponechá vzorec neexponované oblasti, zatímco druhá po vystavení světlu polymeruje polymerujte polymerované a vytvoří se vzorec exponované části.
Vystavení
Poté, co je fotorezistický film pokryt oplatkou, může být tisk obvodu dokončen ovládáním expozice světla. Tento proces se nazývá „expozice“. Můžeme selektivně projít světlo expozicí. Když světlo prochází maskou obsahujícím vzor obvodu, může být obvod vytištěn na oplatku potažený fotorezistickým filmem níže.
Během procesu expozice, čím jemnější je tištěná vzor, tím více komponent může konečný čip pojmout, což pomáhá zlepšit efektivitu výroby a snížit náklady každé složky. V této oblasti je novou technologií, která v současné době přitahuje velkou pozornost, litografie EUV. LAM Research Group společně vyvinula novou technologii fotorezistického suchého filmu se strategickými partnery ASML a IMEC. Tato technologie může výrazně zlepšit produktivitu a výnos procesu expozice litografie EUV zlepšením rozlišení (klíčovým faktorem šířky jemného dolaru).
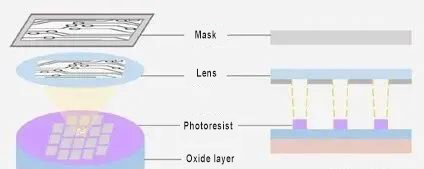
Rozvoj
Krok po expozici je nastříkat vývojáře na oplatku, účelem je odstranit fotorezist v odkryté oblasti vzoru, aby byl odhalen vzor potištěného obvodu. Po dokončení vývoje je třeba jej zkontrolovat různými měřicími zařízeními a optickými mikroskopy, aby se zajistila kvalita obvodu.
Krok 4: Leptání
Po dokončení fotolitografie diagramu obvodu na oplatce se používá proces leptání k odstranění jakéhokoli přebytečného oxidového filmu a ponechání pouze diagramu obvodu polovodičů. K odstranění vybraných přebytečných částí se používá kapalina, plyn nebo plazma. Existují dvě hlavní metody leptání v závislosti na použitých látkách: mokré leptání pomocí specifického chemického roztoku k chemickému reakci k odstranění oxidového filmu a suché leptání pomocí plynu nebo plazmy.
Mokré leptání
Mokré leptání pomocí chemických roztoků k odstranění oxidových filmů má výhody nízkých nákladů, rychlé rychlosti leptání a vysokou produktivitu. Mokré leptání je však izotropní, to znamená, že jeho rychlost je stejná v jakémkoli směru. To způsobuje, že maska (nebo citlivý film) není zcela zarovnána s leptaným oxidovým filmem, takže je obtížné zpracovat velmi jemné schémata obvodu.

Suché leptání
Suché leptání lze rozdělit do tří různých typů. Prvním je chemické leptání, které používá leptací plyny (hlavně vodíkový fluorid). Stejně jako mokré leptání je tato metoda izotropní, což znamená, že není vhodná pro jemné leptání.
Druhou metodou je fyzický rozprašování, které používá ionty v plazmě k ovlivnění a odstranění nadbytečné oxidové vrstvy. Jako metoda anizotropního leptání má v horizontálním a vertikálním směru odlišné rychlosti leptání, takže jeho jemnost je také lepší než chemické leptání. Nevýhodou této metody je však to, že rychlost leptání je pomalá, protože se spoléhá výhradně na fyzickou reakci způsobenou kolizí iontů.
Poslední třetí metodou je reaktivní iontové leptání (RIE). RIE kombinuje první dvě metody, tj. Při použití plazmy pro ionizační fyzické leptání se chemické leptání provádí pomocí volných radikálů generovaných po aktivaci plazmy. Kromě rychlosti leptání přesahující první dvě metody může RIE použít anizotropní charakteristiky iontů k dosažení leptacího vzoru.
Dnes se suché leptání široce používá ke zlepšení výnosu jemných polovodičových obvodů. Udržování uniformity leptání plného vozu a zvyšování rychlosti leptání je kritické a dnešní nejmodernější suché leptací zařízení podporuje produkci nejpokročilejších logických a paměťových čipů s vyšším výkonem.

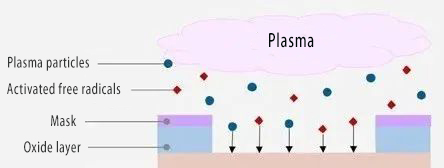
Vetek Semiconductor je profesionální čínský výrobcePotahování karbidu tantalu, Potahování karbidu křemíku, Speciální grafit, Keramika karbidu křemíkuaDalší polovodičová keramika. Vetek Semiconductor se zavázal poskytovat pokročilá řešení pro různé výrobky SIC Wafer pro polovodičový průmysl.
Pokud máte zájem o výše uvedené produkty, neváhejte nás kontaktovat přímo.
Mob: +86-180 6922 0752
WhatsApp: +86 180 6922 0752
E -mail: anny@veteksemi.com



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Čína
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Všechna práva vyhrazena.
Links | Sitemap | RSS | XML | Zásady ochrany osobních údajů |
